东京--(美国商业资讯)-- Resonac Corporation (TOKYO:4004)(总裁:Hidehito Takahashi,以下简称“Resonac”)开发了一种临时键合膜,用于在半导体器件制造工艺(前端工艺)和半导体封装工艺(后端工艺)及其解键合工艺中临时支撑玻璃载体上的晶圆。这种解键合工艺使用氙(Xe)闪光灯照射将晶圆或封装与载体进行解键合,并且可以应用于从晶圆级到面板级的加工。还应指出,与传统的激光烧蚀方法相比,解键合可在更短时间内完成,而不会产生烟灰等异物。该技术已在日本、美国、韩国、中国大陆和中国台湾地区获得专利。*
本新闻稿包含多媒体。此处查看新闻稿全文: https://www.businesswire.com/news/home/20240924931903/zh-CN/
Resonac正在寻找开发合作伙伴,以建立一种新的解键合工艺,并销售新的临时键合膜。
在先进半导体的前端和后端工艺中,晶圆和芯片会通过一种临时键合材料暂时键合到玻璃载体上,以提高可加工性。在经过各种制造加工后,晶圆或封装会与临时键合材料一起从载体上解键合。因此,临时键合材料的性能必须与所有制造工艺兼容,并且残留的临时键合材料必须易于去除。此外,解键合过程必须在短时间内完成而不会造成损坏,以实现高产量和高生产率。而且,最近甚至要求后端工艺和前端工艺达到相同的洁净水平。因此,传统激光烧蚀解键合方法产生的烟尘并不可取。
Resonac的临时解键合膜具有高耐热性和耐化学性,可以在晶圆和封装临时支撑在载体上时表现出足够的键合性能。一旦它们从载体上解键合,薄膜可以在室温下轻松剥除,而不会产生任何残留物。将晶圆从载体上解键合的工艺采用Xe闪光灯照射,可实现大面积批量照射和瞬时高能量输出。通过Xe闪光灯照射局部加热玻璃载体上的金属层可产生瞬时变形,无需施以热应力或机械应力即可快速完成晶圆和封装的解键合。此外,由于解键合机制与树脂分解无关,因此该方法具有工艺清洁的优点,不会产生任何异物,例如激光烧蚀时产生的烟灰。
Resonac认为,这种临时键合膜和新型解键合方法适用于存储器、逻辑和功率半导体以及先进半导体封装的制造工艺。
Resonac将继续通过共同创造为半导体领域的技术创新做出贡献。
*日本专利号:7196857、美国专利号:11840648、韩国专利号:10-2513065、中国大陆专利号:ZL201880077311.4、台湾专利号:I805655,等等
关于Resonac Group
Resonac Group是一家化学公司集团,致力于生产和销售与半导体和电子材料、移动出行、创新使能材料、化学品等相关的产品。集团面向各种产品的中下游供应链提供范围广泛的材料和先进材料技术。2023年1月,Showa Denko Group和Showa Denko Materials Group(原Hitachi Chemical Group)合并为Resonac Group,作为新的企业集团开始运营。
https://www.resonac.com/
力森诺科(中国)投资有限公司
https://www.resonac.com.cn/
免责声明:本公告之原文版本乃官方授权版本。译文仅供方便了解之用,烦请参照原文,原文版本乃唯一具法律效力之版本。
在 businesswire.com 上查看源版本新闻稿: https://www.businesswire.com/news/home/20240924931903/zh-CN/
CONTACT:
先进集成技术研究所
Resonac Corporation
Enomoto Tetsuya
enomoto.tetsuya.xikiz@resonac.com

轻松剥除临时键合膜(照片:美国商业资讯)
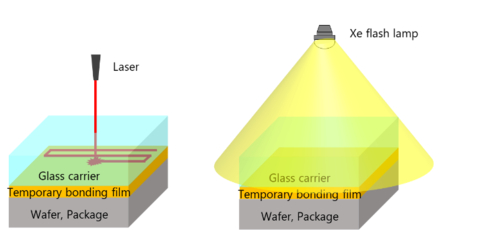
激光和Xe光照射示意图(图示:美国商业资讯)
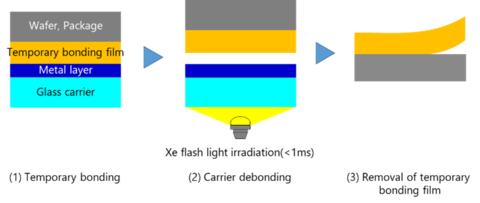
使用Xe闪光灯照射的解键合工艺示意图(图示:美国商业资讯)




